リニアイオンソース特徴
- 成膜前の基板プラズマ処理に最適
- 逆マグネトロンタイプイオンソース
- 最適な磁場設計によりスパッタ圧力でのプラズマ処理が可能
- アノード・カソードにグラファイトを使用し、コンタミを低減
- RF設計を基本とした高い絶縁性能
- 間接冷却方式でパーツ交換が容易な設計
- 整流電源とガス流量のフィードバック制御で常時一定電流を維持
画像
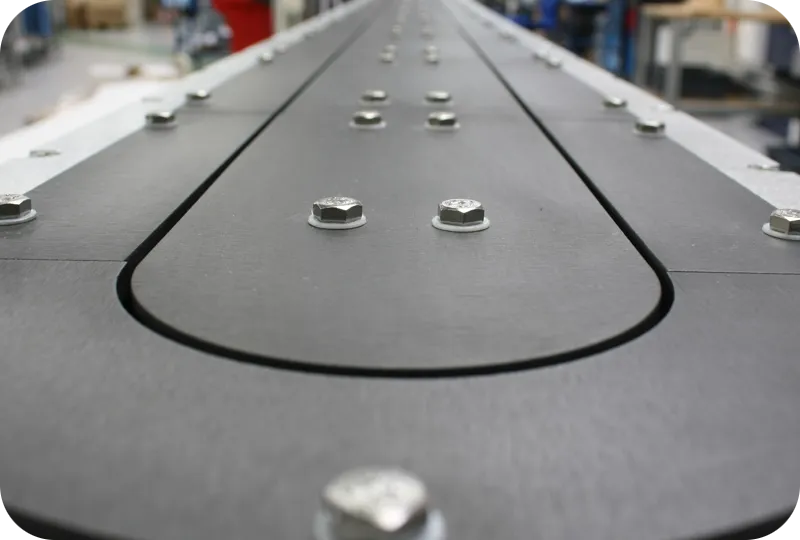
画像
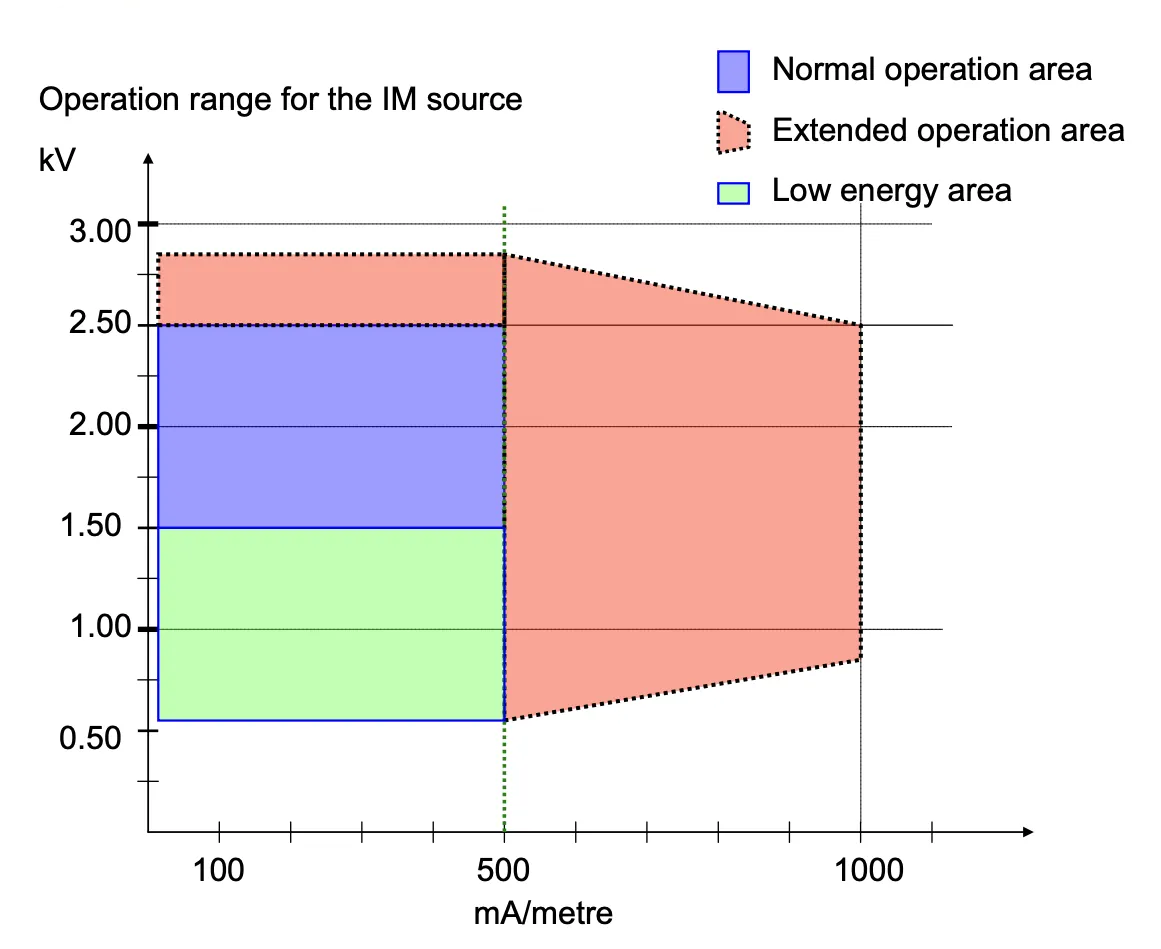
イオンソース動作範囲
- 標準電流:ソース長さ1メートルあたり 0.5A(最大 1A)
- 標準ガス流量:ソース長さ1メートルあたり 25~100sccm (Ar)
- アルゴンと酸素の混合ガスを使用を推奨
ガラス基板へのプラズマ処理有無の結果比較
SEM(操作型電子顕微鏡)による表面分析画像比較、成膜後に分析。リニアイオンソースで1パスプラズマ処理を行った物と行っていない物の比較。プラズマ処理されていない場合では小さな泡状の物が発生(5mm)
プラズマ前処理無し成膜表面
画像
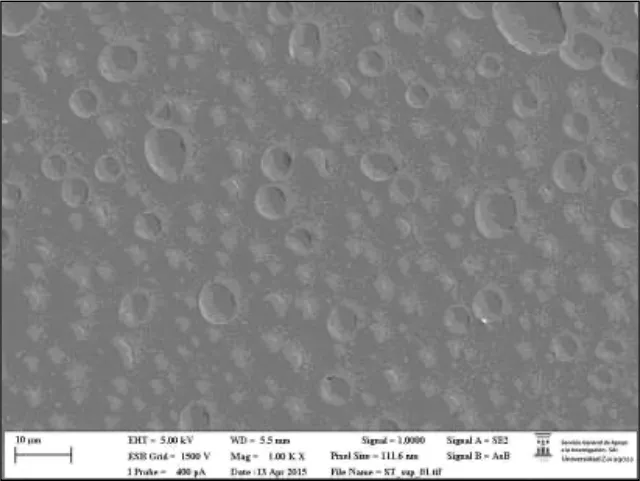
プラズマ前処理後の成膜表面
画像

エッチングレート時例
ポリマー
シリコン:〜20Å / パス
アクリル樹脂:〜38Å / パス
- 使用ガス:O2
- イオンソース:IM400
- 電流値:200mA ビーム @1.5kV
- 基板速度:600mm/min
金属
チタン(Ti):0.5 ~ 1 Å / パス
- 170mA @1.8kV
酸化物
酸化シリコン:5nm / min スタティック
- 使用ガス:Ar
- イオンソース:IM600
- 電流値:300mA ビーム @1.6kV
- 基板速度:スタティック、トータル23分、直径8mmの範囲
イオンソース電源
電源仕様
- 出力電圧:最大2500V(点火時は3000V)
- 出力電流:1A @2000V、ショートサーキット2.5A
- 出力電力:4000W @2000V
- 出力極性:正電位
- 整流モード:電流 0〜2.5A
- 出力コネクタ:フィッシャー105、定格10kV(RG213)
- 主電源:3相400Vac、±10% 50Hz(L1, L2, L3 PE)
- 寸法:標準19インチラック、4U=177mm高さ
- 重量:約12kg
- 動作温度範囲:15-35℃
画像

イオンソース・電源・ガスの接続 - フィードバック制御でビーム安定化
画像







研究開発向け小型イオンソース
- コンパクトデザイン
- 自己中和プラズマ - 基板表面帯電なし
- 可変プラズマエネルギー
- 自動ガスフィードバック制御(IM300電源)
- RFエッチングの代替品として使用可能
- イオンアシスタンス・パターニング・プリクリーニング・成膜除去・PECVD









